반응형
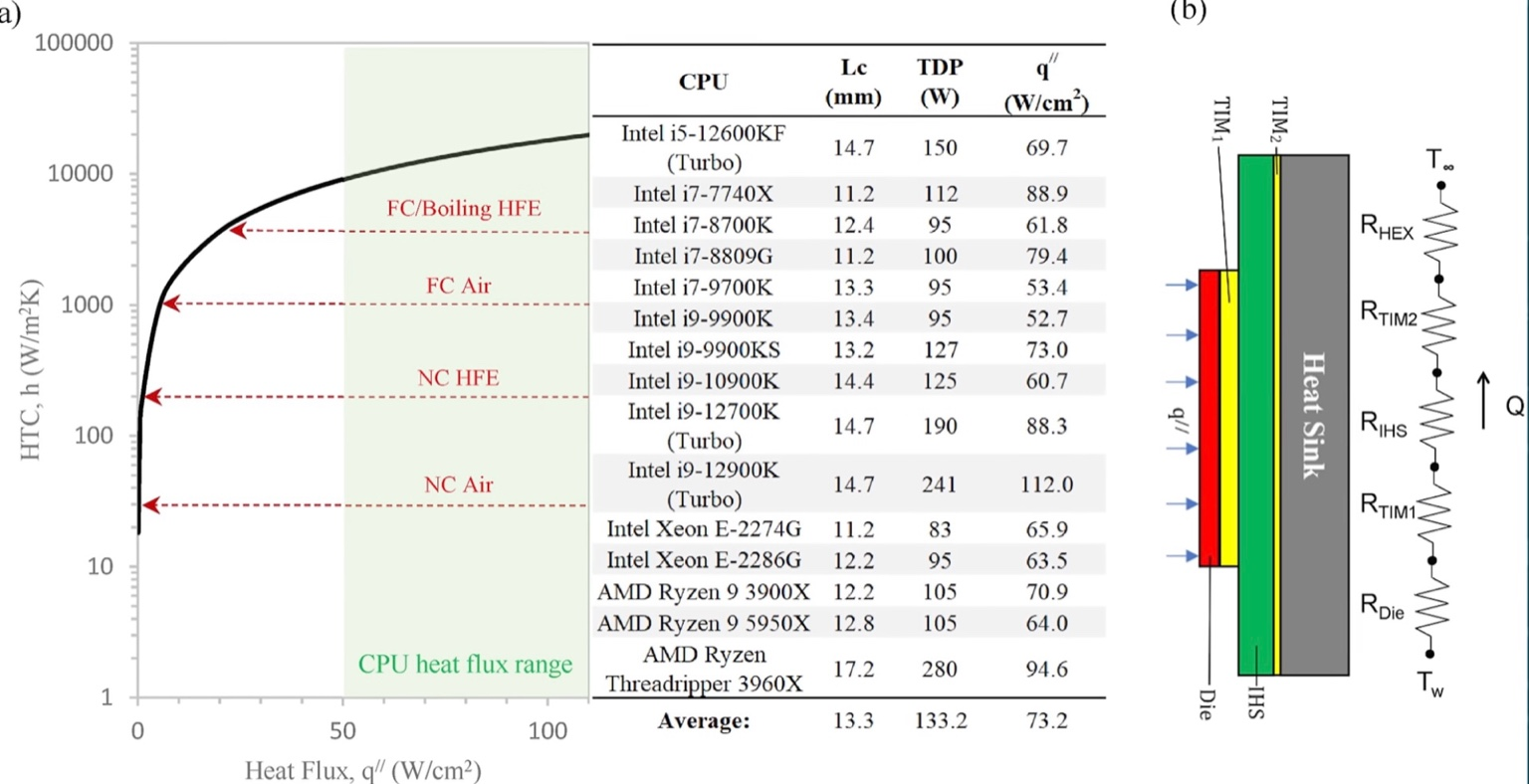
이 이미지는 CPU의 열 전달 성능(Heat Transfer Coefficient, HTC)과 열 플럭스(Heat Flux) 에 대한 분석을 보여주는 과학적 자료입니다. 두 개의 주요 부분으로 구성되어 있습니다:
(a) 그래프 & 표 분석
그래프 (좌측)
- X축: Heat Flux q′′q'' (W/cm²)
- CPU에서 방출되는 열량(단위 면적당).
- 일반적으로 높은 클럭 속도와 높은 전력 소비(TDP)를 가진 CPU는 더 높은 열 플럭스를 가짐.
- Y축: Heat Transfer Coefficient (HTC, W/m²K)
- CPU에서 열을 얼마나 효율적으로 방출하는지 나타내는 지표.
- 높은 HTC일수록 열이 빠르게 전도됨.
- 곡선:
- HTC는 초기에는 빠르게 증가하지만, 일정 수준에서 점진적으로 증가하는 경향을 보임.
- 열 제거 방식(공기 냉각, 액체 냉각 등)에 따라 HTC 값이 다름.
- 표시된 구역:
- NC Air (Natural Convection Air): 자연 대류 공기 냉각
- NC HFE (Natural Convection HFE): 자연 대류를 이용한 특수 액체 냉각
- FC Air (Forced Convection Air): 강제 공기 냉각 (팬 사용)
- FC/Boiling HFE (Forced Convection + Boiling HFE): 강제 냉각과 함께 액체의 끓음 현상 활용
- CPU Heat Flux Range (녹색 영역):
- 현재 일반적인 CPU들이 발생하는 열 플럭스의 범위 (
0110 W/cm²) - 대부분의 CPU가 강제 공기 냉각(FC Air)에서 작동하는 수준.
- 현재 일반적인 CPU들이 발생하는 열 플럭스의 범위 (
표 (우측)
이 표는 다양한 CPU의 열적 특성을 비교한 데이터입니다.
- Lc (mm): CPU 다이 크기 (방열면적)
- TDP (W): Thermal Design Power (열 설계 전력)
- Heat Flux q′′q'' (W/cm²): 단위 면적당 방출되는 열량
주요 패턴
- 고성능 CPU일수록 높은 TDP와 Heat Flux를 가짐.
- 예:
- Intel i9-12900K (Turbo) → TDP 241W, q′′=112.0q'' = 112.0 W/cm²
- AMD Threadripper 3960X → TDP 280W, q′′=94.6q'' = 94.6 W/cm²
- 예:
- CPU 다이 크기(Lc)가 작을수록 q′′q'' 가 증가.
- 예: Intel i7-7740X (Lc = 11.2mm, q′′=88.9q'' = 88.9 W/cm²)
- 작은 면적에서 더 많은 열을 방출해야 하므로 열 밀도가 증가함.
- AMD Ryzen 시리즈는 상대적으로 낮은 q′′q'' 를 보임.
- Ryzen 9 5950X (64.0 W/cm²)
- 이는 AMD의 다이 설계(칩렛 구조) 때문일 가능성이 있음.
(b) CPU 열전달 모델 (우측 그림 분석)
이 그림은 CPU 내부의 열 저항 모델을 보여줍니다.
- 구성 요소:
- Die (CPU 코어, 빨간색): 가장 높은 열 플럭스를 가짐.
- TIM1 (Thermal Interface Material 1, 노란색): CPU 다이와 IHS(히트스프레더) 사이의 열전도 물질.
- IHS (Integrated Heat Spreader, 녹색): CPU 표면을 덮는 금속판으로, 열을 고르게 퍼뜨리는 역할.
- TIM2 (Thermal Interface Material 2, 노란색): IHS와 히트싱크 사이의 열전도 물질.
- Heat Sink (회색): CPU에서 방출된 열을 흡수하여 공기 또는 액체로 전달.
- 열 저항 경로:
- 열 흐름 (QQ)이 CPU 내부에서 방열판으로 이동하면서 여러 열 저항 요소를 거침.
- RDieR_{Die}, RTIM1R_{TIM1}, RIHSR_{IHS}, RTIM2R_{TIM2}, RHEXR_{HEX} 순으로 열 저항을 가짐.
- TIM(Thermal Interface Material)이 좋지 않으면 열 저항이 증가하고 열 방출이 어려워짐.
결론 및 주요 시사점
- CPU의 열 플럭스 범위는 약 50~110 W/cm²이며, 대부분의 공냉 방식에서 처리 가능.
- 고성능 CPU는 높은 TDP를 가지며, 다이 크기가 작을수록 단위 면적당 방출하는 열량이 증가.
- 열전달 성능을 높이려면 TIM(열전도 물질)과 히트싱크의 품질이 중요.
- 강제 대류 냉각(FC Air) 이상의 냉각 방식이 필요한 CPU가 증가하고 있음 (예: i9-12900K, Threadripper 3960X).
- CPU 열 관리를 위해 열저항(R) 요소를 줄이는 것이 중요 (예: 리퀴드 메탈 TIM 사용).
이 데이터는 CPU 열 관리 전략을 수립하는 데 유용하며, 공냉과 수냉 시스템 설계에 중요한 정보를 제공할 수 있습니다.
반응형
'IT생활' 카테고리의 다른 글
| 집 수영장 아래에 배관을 설치하고 Heat Exchanger(열교환기) 를 활용하여 컴퓨터 수냉 시스템을 구축하기 (0) | 2025.02.08 |
|---|---|
| CPU 다이(Die)에서 히트싱크(Heat Sink)와 직결(Direct Die Cooling) 하는 방법 (0) | 2025.02.08 |
| 네트워크 인터페이스 개념: Bridge, Bond, VLAN, IntPort 상세 분석 (2) | 2025.02.08 |
| 디코딩도 GPU가 처리하게 만들면, 인코딩 속도도 좀 더 빨라지지 않을까? (0) | 2025.02.08 |
| 그래픽카드 한 개에서 NVENC 개수와 인코딩 성능 관계 분석 (0) | 2025.02.08 |



